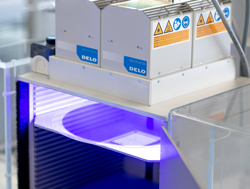 DELO a développé une nouvelle approche pour l’encapsulation de type Fan Out Wafer-Level Packaging (FOWLP). Les études de faisabilité réalisées par le fabricant montrent clairement l’avantage d’utiliser des matériaux d’encapsulation polymérisables aux UV plutôt qu’à la chaleur en termes de déformation des wafers et de risques de déplacements des composants. En outre, ce procédé de polymérisation est plus rapide et réduit la consommation d’énergie.
DELO a développé une nouvelle approche pour l’encapsulation de type Fan Out Wafer-Level Packaging (FOWLP). Les études de faisabilité réalisées par le fabricant montrent clairement l’avantage d’utiliser des matériaux d’encapsulation polymérisables aux UV plutôt qu’à la chaleur en termes de déformation des wafers et de risques de déplacements des composants. En outre, ce procédé de polymérisation est plus rapide et réduit la consommation d’énergie.
La déformation des plaquettes et le possible mouvement des puces sont des effets indésirables typiques du packagaing FOWLP, un procédé performant utilisé dans le secteur des semi-conducteurs permettant d’encapsuler de nombreuses puces sur un support. Même si les techniques du procédé FOWLP sont sans cesse améliorées, les problèmes associés au moulage sous pression restent d’actualités.
La déformation des wafers (en général un bombé) est dû au retrait chimique se produisant lorsque la résine de moulage sous pression (LCM) polymérise et refroidit après le processus de moulage. La deuxième contribution au gauchissement découle des différences de coefficients de dilatation thermique (CTE) entre les puces en silicium, le matériau de moulage et le substrat. Le décalage des puces résulte de matériaux de moulage hautement chargés et donc pâteux, qui ne peuvent être appliqués qu’à des températures élevées et à de hautes pressions. Les puces étant montées sur des supports par un collage provisoire, l’élévation de la température peut affaiblir l’adhésif provisoire, diminuant ainsi sa fonction de maintien des puces en place. Simultanément, la pression requise pour diffuser la résine de moulage exerce une force sur chaque puce.
 Pour résoudre ces problèmes, DELO a réalisé une étude de faisabilité à l’aide d’un modèle simple de puces factices collées sur un substrat. Pour cette configuration, la plaquette de support a été recouverte d’un adhésif provisoire et les puces ont été positionnées face vers le bas. Ensuite, la plaquette a été encapsulée avec un matériau DELO de faible viscosité, polymérisé à la lumière UV avant de retirer la plaquette de support. Des résines de moulage à forte viscosité et polymérisant à la chaleur sont généralement utilisés dans des applications de ce type.
Pour résoudre ces problèmes, DELO a réalisé une étude de faisabilité à l’aide d’un modèle simple de puces factices collées sur un substrat. Pour cette configuration, la plaquette de support a été recouverte d’un adhésif provisoire et les puces ont été positionnées face vers le bas. Ensuite, la plaquette a été encapsulée avec un matériau DELO de faible viscosité, polymérisé à la lumière UV avant de retirer la plaquette de support. Des résines de moulage à forte viscosité et polymérisant à la chaleur sont généralement utilisés dans des applications de ce type.
Les expériences réalisées, au cours desquelles DELO a aussi comparé le gauchissement d’un encapsulant à polymérisation thermique avec celui d’un produit à polymérisation aux UV, ont démontré que la déformation intervient lorsque des matériaux de moulage typiques refroidissent après une polymérisation à la chaleur. Ainsi, l’adoption de la polymérisation à température ambiante à l’aide de la lumière UV au lieu de la chaleur réduit considérablement l’impact des différences de CTE entre la résine de moulage et le support, ce qui minimise la déformation.
L’utilisation d’un matériau à polymérisation aux UV permet aussi de réduire la teneur en charges et, par conséquent, la viscosité et le module de Young. Durant les tests, une résine proposant une viscosité de 35 000 mPa-s et un module de Young de 1 GPa a été utilisée. Cette viscosité modérée permet de réduire les contraintes pouvant conduire aux déplacements des puces car aucune chaleur ou pression élevée n’est nécessaire pour diffuser le matériau de moulage. Les résines thermiques généralement utilisés ont une viscosité d’environ 800 000 mPa-s et un module de Young à deux chiffres.
Globalement, l’étude a montré que l’utilisation de résines de moulage pour grandes surfaces et polymérisation aux UV facilite la production de package suivant le procédé FOWLP en réduisant la déformation et le déplacement des puces. Malgré l’importante disparité de CTE entre les matériaux utilisés, le processus reste polyvalent grâce à l’absence de variation de température. En outre, la polymérisation à la lumière UV réduit à la fois le temps de polymérisation et la consommation d’énergie.
DELO participera au SEMICON Europa à Munich du 12 au 15 novembre 2024 pour présenter en détail ses conclusions et ses solutions de collage pour packaging avancés.